삼성전자가 반도체부문 세계 최초란 타이틀을 거머쥔 1994년. 회사가 내놓은 D램은 용량이 256메가비트(Mb), 회로 선폭은 250나노미터(㎚)였다.
25년이 지난 올해 초 삼성전자가 내놓은 세계 최초 3세대(1z) 10나노급 D램(8Gb)은 이에 비해 용량은 31.25배 늘고, 선폭은 25배 줄었다. 회로 미세화를 통해 더 많은 부품을 한 곳에 모으는 집적화를 이루고, 전자간 이동속도가 빨라져 성능이 비약적으로 개선됐다.
문제는 반도체 미세화가 만만치 않다는 것이다. 회로 선폭을 좁힐수록 메모리 셀 간 전자가 간섭하며 오작동 가능성이 커지고, 발열이 증가해서다. 기술개발 비용도 문제다.
인텔이 1970년최초로 개발한 D램이 선폭 10마이크로미터(㎛)로(용량 1킬로비트(Kb)) 24년 뒤 삼성제품이 선폭을 이에 비해 40배 줄인 것과 비교하면 미세화 속도가 확연히 더뎌졌음을 알 수 있다. 25만6000배에 달했던 용량 증가세가 고꾸라진 것도 그 이유다.
이에 반도체 후공정이 회로 선폭 미세화 대안으로 떠오르고 있다. 반도체 공정은 설계한 회로를 웨이퍼에 새겨 모양대로 원판을 깎고 전기가 흐르도록 하는 전공정, 전기배선을 연결한 뒤 개별 제품을 잘라내고 포장하는 후공정으로 나뉜다.
그간 후공정은 반도체 공정의 맨 끝단에 위치하며 보조하는 등 역할이 한정된 것으로 인식됐다. 최근에는 "모든 반도체는 후공정으로 통한다"는 말이 나올 정도로 반도체 혁신 '선두주자'로 자리매김하는 중이다.
◇ 메모리 속을 '알차게'

삼성전자와 SK하이닉스 두 회사 모두 메모리 반도체 후공정에 강점을 지니고 있다. 첫 반도체 사업으로 메모리를 낙점해 설계부터 생산, 포장까지 반도체 공정 '첫 단에서 끝단'까지를 전부 자체 역량으로 소화하는 역량을 쌓아서다.
후공정은 다음 세대 메모리 제품으로 이어지는 징검다리 역할을 한다. 하이닉스는 2013년 세계 최초로 고대역폭메모리(HBM) D램 개발에 성공했다. 기존 D램보다 데이터 처리속도를 끌어올린 차세대 메모리다. 최근 회사는 HBM 규격 'HBM2'보다 처리 속도를 50% 높인 'HBM2E'를 개발했다.
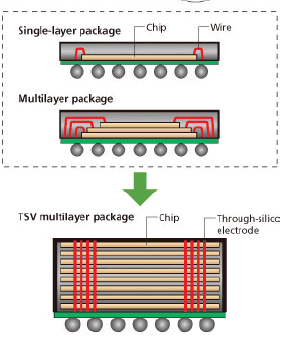
데이터가 드나드는 통로를 더 많이 뚫은 것이 비결이다. 실리콘 관통전극(TSV)을 통해 수천여개의 구멍이 뚫린 상단과 하단칩을 수직으로 관통했다. 데이터 덩어리인 전자가 드나드는 통로가 2차선에서 3차선으로 넓어진 셈이다.
더욱이 TSV로 칩들 간 신호를 주고받는 길이가 짧아져 속도는 더 빨라지고 전력소모도 줄었다. 완제품 크기도 더 작아질 수 있다. 전극이 칩 외부로 삐져나와야 하는 와이어본딩(WB) 기술보다 제품 크기를 30% 이상, 전력 소모는 50% 이상 줄이는 것이 가능하다고 하이닉스 관계자는 설명했다.
앞으로 HBM 규격은 빠른 처리속도가 필수인 4차산업 혁명이 진행되면서 머신러닝, 슈퍼컴퓨터, 인공지능 등 여러 분야에 두루 쓰일 전망이다.
◇ 비메모리도 '더 꼼꼼하게'
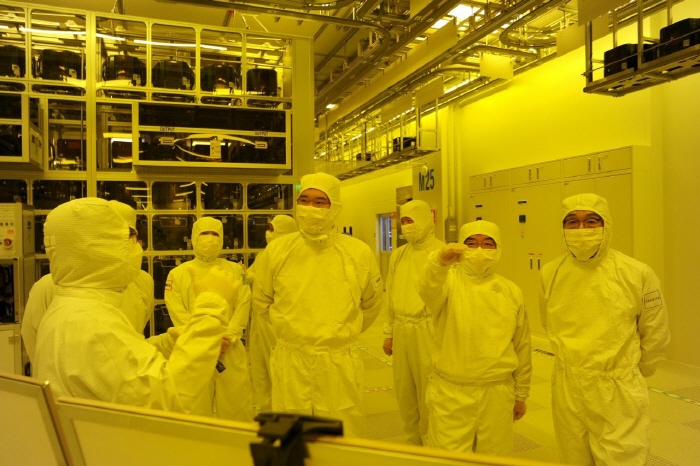
국내 업체들은 비메모리 반도체 후공정에는 상대적으로 취약한 것으로 전해진다. 메모리 반도체에 비해 시작이 늦어서 역량 내재화에 뒤늦게 뛰어들어서다. 한국반도체산업협회 관계자는 "비메모리 반도체의 경우 후공정 기술력 세계 10위권에 국내 기업이 한 곳도 포함되지 않았다"고 설명했다.
삼성전자는 비메모리부문에 적용할 후공정 기술개발에 박차를 가하고 있다. 이재용 부회장이 지난 4월 총 133조원을 투자해 2030년까지 비메모리 반도체 1위에 등극하겠다고 내놓은 청사진을 '지원 사격'하기 위해서다.
최근 일본이 한국을 수출 우대국(화이트리스트)에서 제외하고 첫 행선지로 이 부회장이 반도체 후공정이 이뤄지는 온양 및 천안 사업장을 찾은 것도 '후공정에 대한 총수의 관심'을 드러낸 것이란 분석이 나왔다.
삼성전자가 삼성전기에서 두달 전 인수한 '패널 레벨 패키지(PLP)' 기술이 대표적이다. 이 기술은 전극이 인쇄회로기판(PCB)을 거치지 않고 메인기판으로 직행하도록 알뜰하게 포장하는 방법이다. PCB가 필요 없어 크기는 줄이면서, 전자 통로를 늘려 속도는 올릴 수 있어 '두마리 토끼'를 잡는다.(※관련기사 : '적자라도 괜찮아' 삼성전자, 차세대 먹거리 집중)
반도체 업계는 삼성전자가 지난해 출시한 갤럭시워치에 들어간 어플리케이션프로세서(AP)뿐만 아니라 메모리 및 비메모리 반도체 전반에 PLP 기술을 적용할 것으로 보고 있다.
삼성전자에게 후공정 경쟁력 제고는 반도체 위탁생산(파운드리)부문 대만 TSMC와 경쟁에서도 절실하다. TSMC는 과거 '팬아웃 웨이퍼 레벨 패키지(FO-WLP)' 기술을 개발해 2016년부터 애플 아이폰 AP 물량을 싹쓸이 했다.
과거 삼성과 TSMC가 나눠 갖던 물량을 TSMC가 독점했다. 삼성은 지난해부터 TSMC에 앞서 극자외선(EUV) 기반 7나노 공정 양산에 들어가며 전공정에선 승기를 잡았고, 후공정까지 뒤집기를 시도하려는 복안이다.
시장조사기관 트렌스포스에 따르면 올해 2분기 매출액 기준 파운드리 시장 점유율 TSMC가 49.2%로 과반에 육박했고 삼성전자는 18%로 아직 격차가 크다. 업계 관계자는 "10나노 이하 공정이 개발됐지만 회로 선폭을 줄이는 것은 여전히 제약이 많다"며 "후공정이 반도체 혁신 보완책으로 떠오를 것"이라고 전망했다.