
차세대 고대역폭메모리(HBM) 패권 경쟁이 달아오르면서 무대 뒤에선 '풀칠 전쟁'이 벌어지고 있습니다. 메모리를 수십 단 이상 높이 쌓아 올릴 때 빠질 수 없는 장비가 바로 본더인데요. 지금까지는 'TC본더'라는 풀로 칩을 붙였다면, 이제는 '하이브리드 본더'라는 강력한 본드가 새 주자로 부상하고 있습니다.
풀과 본드, 뭐가 다를까?
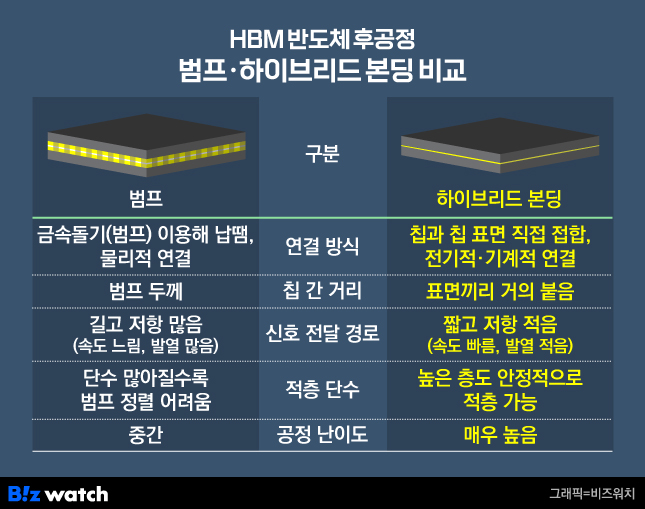
쉽게 말해 TC본더는 반도체 칩과 칩 사이에 '풀'을 바른 뒤 열과 압력을 가해 붙이는 방식입니다. 여기서 풀 역할을 하는 게 바로 '마이크로 범프'라는 아주 작은 돌기죠. 지금까지 HBM은 이 범프를 하나하나 붙여 쌓아 올리는 방식으로 발전해왔습니다. 책 사이에 스펀지를 껴 넣어 올리는 것과 비슷합니다. 안정적으로 쌓을 순 있지만 두께가 점점 두꺼워지고 무게도 늘어나죠.
이 방식엔 분명한 한계가 있습니다. 앞으로 인공지능(AI) 반도체에 들어갈 HBM은 20단 이상 쌓아야 하는데 범프를 쓰는 방식으론 높이가 버겁습니다. 층층이 쌓을수록 발열과 전력 소모도 커집니다.
이때 등장한 해법이 바로 하이브리드 본더입니다. 범프 자체를 아예 없애고 칩과 칩의 구리 배선을 직접 맞닿게 연결하는 방식입니다. 포스트잇처럼 얇은 종이 표면을 본드로 바로 붙이는 느낌이라고 보면 됩니다. 덕분에 전체 두께를 크게 줄일 수 있고 접합도 단단해져 발열 문제까지 줄어듭니다. 더 얇고 효율적인 HBM을 만들 수 있는 길이 열리는 거죠.
숫자로 보면 당장은 TC본더가 주류입니다. 시장조사업체 욜 그룹에 따르면, 오는 2030년께 TC본더 시장은 9억3600만 달러 규모로 하이브리드 본더(3억9700만 달러)의 2배 이상입니다. TC본더로도 HBM16단까지는 규격을 맞출 수 있고, 하이브리드 장비는 2배 이상 비싸며 공정 난이도가 높기 때문이죠.
하지만 앞서 설명했듯 20단 이상 적층 경쟁이 본격화되면 이야기가 달라집니다. 얇고 촘촘하게 붙일 수 있는 하이브리드 본더가 사실상 필수 카드가 되기 때문입니다. 특히 HBM 시장에서의 핵심은 HBM4와 그 이후 세대죠. 단기적으로는 TC본더가 캐시카우 역할을 이어가겠지만 중장기적으로 하이브리드 본더가 주연 무대에 오를 수밖에 없다는 게 업계 중론입니다.
본더 삼국지…'2막 커튼' 오른다
현재 판도는 말 그대로 삼국지입니다. TC본더 시장을 사실상 독식해온 한미반도체는 인천에 1000억 원을 들여 하이브리드 전용 공장을 짓고 있습니다. 2027년 출시를 목표로 전공정 기업 테스와도 손을 잡았죠.
여기에 한화세미텍이 신흥 강자로 빠르게 치고 올라옵니다. SK하이닉스와 800억 원대 TC본더 계약을 성사시킨 데 이어 내년 초 'SHB2 나노'라는 하이브리드 본더 출시를 예고했어요. 머리카락 굵기의 1000분의 1에 불과한 0.1㎛ 정렬 정밀도를 내세울 만큼 기술 자신감도 드러냈습니다.
LG전자 생산기술연구원도 학계와 정부 과제를 등에 업고 추격전에 뛰어들었습니다. 인하대와 손잡고 칩 정렬 오차를 줄이는 기술 특허를 준비 중이고요. 글로벌 강자인 네덜란드 BESI는 정밀도 50나노미터 이하를 내걸며 "넘어올 테면 넘어와 봐"라는 태도를 보이고 있습니다.
결국 반도체의 미래는 '풀칠' 하나에 달려 있습니다. 누가 더 빨리, 더 얇게, 더 정교하게 붙이느냐가 판도를 바꿀 열쇠죠. TC본더가 깔아놓은 무대 위로 이제 하이브리드 본더라는 새로운 주연이 등장했습니다. 반도체 풀과 본드의 전쟁, 이제 2막의 커튼이 열리고 있습니다.
[테크따라잡기]는 한 주간 산업계 뉴스 속에 숨어 있는 기술을 쉽게 풀어드리는 비즈워치 산업팀의 주말 뉴스 코너입니다. 빠르게 변하는 기술, 빠르게 잡아 드리겠습니다. [편집자]

























